汽车芯片,加速出击
车轮上的计算机。这就是人们目前对汽车的看法。实际上,从打开车窗到计算当前扭矩需求下的最佳油气混合物,汽车中发生的一切都由微控制器监控和驱动。但是,就计算能力进入汽车的程度而言,这只是刚刚触及表面。
自动驾驶汽车L3和robotaxis的崛起
自动驾驶时代即将到来,汽车行业的计算需求也将随之进入一个新时代。自动驾驶汽车需要大量传感器来扫描环境,并为汽车提供模拟人类驾驶所需的数据。IDTechEx 的 "2024-2044 年自动驾驶汽车和机器人轴 "报告发现,领先的 SAE 4 级机器人轴拥有多达 40 个独立传感器。再加上汽车市场即将推出的自动驾驶技术,这将推动汽车传感器市场实现 13% 的 10 年复合年增长率。然而,如果没有高性能计算来处理传感器的数据并构建环境的三维渲染图,为车辆的程序化驾驶策略提供依据,那么传感器本身几乎毫无用处。
高性能计算(HPC)从传感器阵列中获取实时数据输出,并执行若干重要流程。它所面临的两个关键挑战是传感器融合和物体分类,而对于完成这两项工作的顺序存在一些分歧。有些人认为早期融合是最好的,在这种情况下,所有传感器数据都会被整合到场景的三维渲染中,然后由车辆的高性能计算单元运行人工智能算法,对检测到的每个物体进行识别和标记。另一些人则认为,应从每个传感器生成一个物体列表,然后将结果进行融合。这样做的好处是可以交叉参考每个传感器的检测结果,并检查是否一致。但这样做的缺点是在处理来自不同传感器的目标列表之间的差异时面临挑战。
自主计算SOC

来源:IDTechEx IDTechEx
无论采用后期融合还是早期融合,HPC 仍将以图像处理的形式进行大量数据处理,并运行人工智能算法进行图像分类和制定驾驶策略。处理这些任务的关键部件是图形处理器(GPU)、计算处理器(CPU)和内存。通常情况下,这些都是独立的分立组件;然而,自动驾驶汽车对 HPC 的特殊要求导致它们被组合到称为 SOC 或片上系统的单芯片上。这些芯片将 GPU、CPU、RAM 等集成到一块硅片上。理想的 SOC 可以接收来自车辆所有自动驾驶传感器的数据,对其进行处理,对所有检测到的物体进行识别和分类,并根据驾驶策略创建一套转向、油门和制动操作。因此,SOC 负责整个自动驾驶系统。
要满足自动驾驶的计算要求,关键在于将所有这些功能集成到一个芯片上。由于物理分隔几乎为零,芯片的每个部分都能以接近零的延迟、几乎无噪声和巨大的带宽交换数据。这与将分立元件分布在印刷电路板上的做法截然不同,更多的接口和更多的数据线会带来噪音和延迟。
GPU 是这一难题的关键部分;其图像处理能力,加上通过深度学习和神经网络运行人工智能算法的适用性,使其成为 SOC 的基石。这也是我们看到 Nvidia 在自动驾驶汽车领域获得牵引力的原因。Nvidia 在为计算领域的图形应用开发 GPU 方面有着悠久的历史,并且能够灵活运用,将其专业技术带入汽车行业。其 Xavier 和 Orin 平台一直是自动驾驶汽车计算处理的主力。
Mobileye 是该行业的另一个先驱。该公司成立于 1999 年,很快就给人留下了深刻印象并声名鹊起,引起了英特尔公司的兴趣,并最终被收购。现在,它再次上市,并已进入许多消费类汽车,为 ADAS 应用提供动力。
Mobileye 和 Nvidia 最近一直在提高计算能力,从几 TOPS(每秒太赫兹运算)到几十 TOPS,再到现在的几百 TOPS,目标是几千 TOPS。这些改进的主要途径是台积电和三星等领先代工厂采用越来越小的节点尺寸。它们一直在通过其支持的代工厂采用更小的节点技术来实现这些改进。
不断发展的半导体技术

代工技术。来源:IDTechEx IDTechEx
近年来,IDTechEx 看到 Mobileye、Nivida 和其他公司从 2018 年的 28 纳米发展到 2021 年的 7 纳米 FinFET 解决方案和更低的工艺。不过,这些代工厂目前正在生产 5 纳米以下的技术,并在未来向 1 纳米以下的技术迈进。IDTechEx 发现,每当节点技术减半,计算能力就会增加 10 倍。这种关系在 IDTechEx 的《2023-2033 年用于自动驾驶汽车和电动汽车的半导体》报告中得到了明确体现。但是,追求越来越小的节点尺寸将变得越来越昂贵。台积电 3nm 技术的单个 300mm 晶圆成本约为 20,000 美元,随着各行各业对 3nm 以下技术的需求,从普通计算应用(如手机、笔记本电脑和 PC)到汽车行业的新需求,这一价格还将继续增长。

汽车 SOC 性能(TOPs)。来源:IDTechEx 来源:IDTechEx
因此,汽车 HPC 开发人员需要考虑如何优化现有技术,以获得最高性能。IDTechEx 所看到的一种方法是更加关注人工智能 (AI)、神经网络 (NN) 和深度学习 (DL) 加速器。这些加速器使用新的数据人工智能增强型数据处理策略,减少了对 GPU 传统方法的依赖。这能以非常低廉的成本提升芯片性能,减少对较小节点技术的投资,甚至产生整体效率效益。IDTechEx 发现,人工智能在 Mobileye 和瑞萨(Renesas)等领先的二级厂商的 SOC 框图中越来越常见。不过,Recogni 的前景尤其引人关注。Recogni 是一家为自动驾驶 SOC 应用开发 AI 加速器的初创公司,有望带来改变游戏规则的计算能力和效率。
即使节点尺寸缩小,人工智能解决方案富有想象力,大型计算机芯片行业的发展速度仍然在放缓。摩尔定律认为,计算能力应每两年翻一番,这一已有几十年历史的经验公式直到最近才被打破。有人说,摩尔定律开始放缓,因为该行业面临着越来越困难的技术挑战,要实现的增量越来越小。还有人说,摩尔定律已死。
为应对摩尔定律的放缓和单片集成电路制造成本的大幅增加,一个突出的解决方案是 "芯片 "概念。芯片组的核心概念是将单片集成电路解构为不同的功能块,将这些功能块转化为独立的芯片组,然后在封装层进行重新组装。与传统的单片集成电路相比,芯片组处理器的最终目标是保持或提高性能,同时降低总体生产成本。芯片设计的功效在很大程度上依赖于封装技术,特别是那些用于互连多个芯片的技术,因为它们会对整个系统的性能产生重大影响。这些先进的半导体封装技术包括 2.5D IC、3D IC 和高密度扇出晶圆级封装等方法,统称为 "先进半导体封装"。IDTechEx 在题为 "2022-2032 年先进半导体封装 "的研究报告中对这些尖端技术进行了广泛研究。它们有助于将通常在不同工艺节点生产的多个芯片融合到一个基板上。利用紧凑的凸点尺寸可以实现这种融合,从而提高互连密度和集成能力。
纵观当前先进半导体封装技术在业界的应用,我们不妨以服务器 CPU 领域为例进行说明。虽然大多数当代服务器 CPU 都是围绕单片系统(SoC)设计构建的,但也出现了值得注意的发展。2021 年,英特尔宣布即将推出服务器 CPU "蓝宝石急流",它将采用一种新颖的方法。这款下一代 CPU 将通过英特尔的嵌入式多芯片互连桥(EMIB)构建成一个四芯片模块,代表了一种 2.5D 高级半导体封装解决方案。
与此同时,AMD 还利用先进的 3D 半导体封装技术来提高服务器 CPU 的性能。在其最新的服务器 CPU Milan-X(2022 年 3 月发布)中,AMD 采用了三维封装策略,将缓存芯片直接堆叠在处理器顶部。根据 AMD 的说法,与传统的 2D 封装相比,这一创新使互连密度显著提高了 200 倍。这些发展不仅局限于 CPU,数据中心领域还见证了先进半导体封装技术与加速器等其他组件的集成。英伟达公司(NVIDIA)是其中的重要一员,自2016年以来,该公司的高端GPU加速器一直采用台积电的2.5D封装技术,即晶圆上芯片(CoWoS)。
英特尔和 AMD 都在其尖端产品中采用了这种封装技术,这表明先进半导体封装技术在整个行业的应用正在不断扩大。这一趋势超越了服务器 CPU,涵盖了各种数据中心组件。随着行业格局的演变,这些创新的封装方法将在提高性能、集成度和效率方面发挥关键作用。
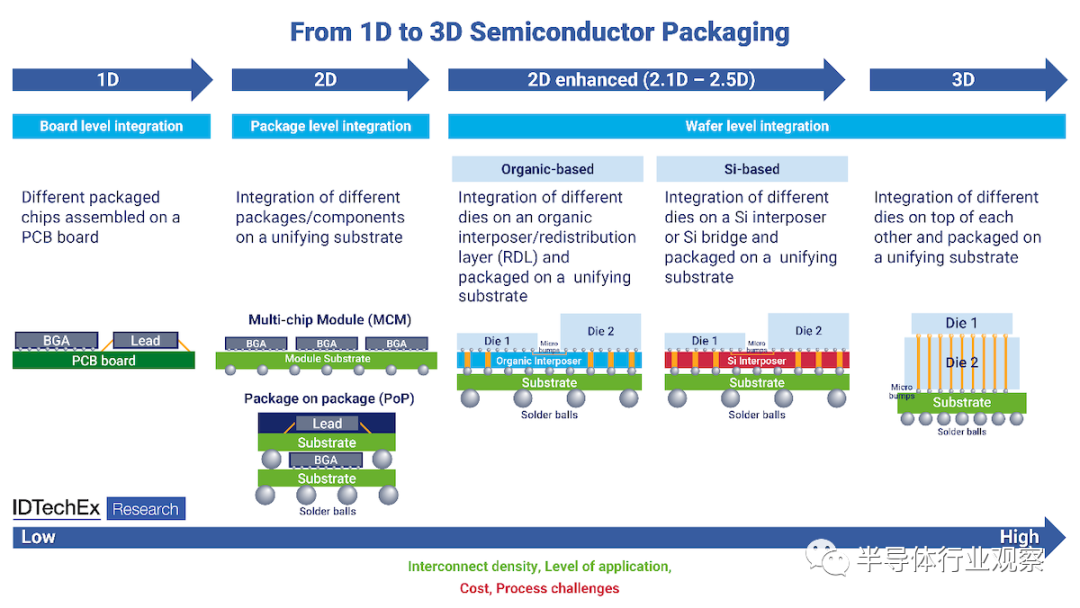
半导体封装的演变。来源:IDTechEx 资料来源:IDTechEx 报告 "2022-2032 年先进半导体封装"。
在可预见的未来(10-15 年内),受不断升级的处理要求和以最小功耗获得最大带宽的必要性的驱动,汽车行业的发展轨迹将与云计算和高性能计算 (HPC) 市场的发展轨迹相似。这一轨迹涉及在封装层面整合各种知识产权(IP)和硅元件,以实现基本功能和最佳性能。在自动驾驶汽车(AV)计算处理器方面,封装领域将出现在同一封装内集成多个硅元件,并采用先进的 2.5D 和 3D 设计方法。
随着汽车对高性能计算的需求日益增长,以及性能持续增长的必要性,汽车计算机的技术也将迅速发展。3纳米以下的节点尺寸、芯片设计、对人工智能加速的更多依赖、2.5D封装,甚至3D封装都将成为汽车自主技术高性能计算的正常组成部分。计算机在汽车中的应用已有几十年的历史,但未来的技术将使今天的普通汽车看起来像智能手机世界中的座机技术。





















